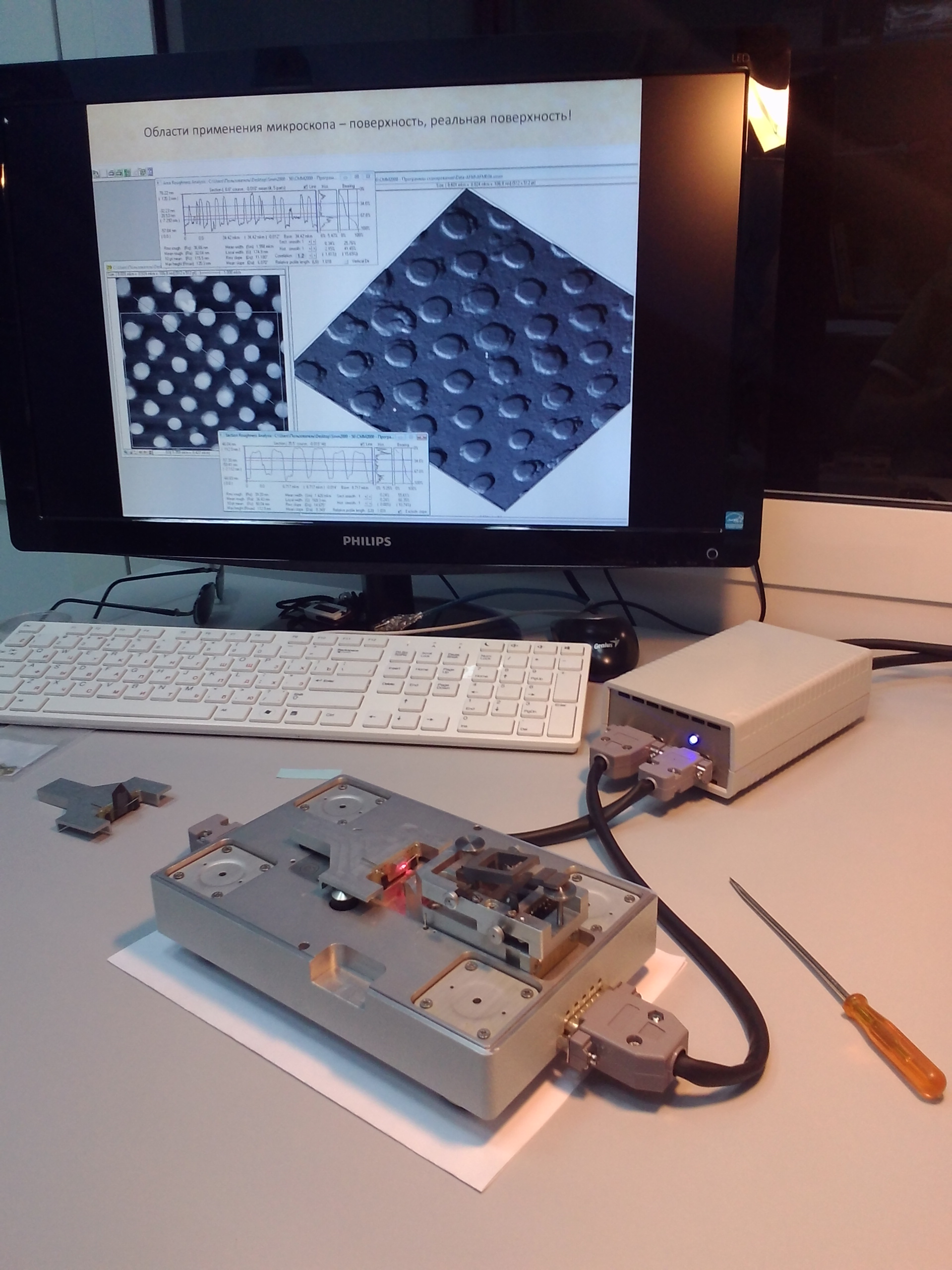
Сканирующий зондовый микроскоп СММ-2000
ОАО "Завод ПРОТОН-МИЭТ" Москва, Зеленоград www.z-proton.ru
Сканирующий зондовый микроскоп СММ-2000 предназначен для измерений геометрических и физических параметров топографии поверхности образцов с нанометровым пространственным разрешением без их вакуумирования
(диапазон измерений от 0,1нм до 30мкм). Микроскоп СММ-2000 применяется при проведении фундаментальных и прикладных научных исследований, а также для технологического контроля.
Микроскоп СММ-2000 - мультирежимный, он имеет три базовых режима - STM (сканирующая туннельная микроскопия), AFM (атомно-силовая микроскопия) и VAFM (вибрационная атомно-силовая микроскопия).
Разрешение микроскопа: 0,1 А в режиме STM, до 0,1-20 А в AFM и доп. режимах (зависит от типа зонда).
Поле кадров: 15x15x2,5мкм и 2,5x2,5x0,5мкм.
Предел допускаемой погрешности измерений линейных размеров по осям X,Y и Z составляет 10нм ±10% измеряемого размера.
Дополнительные режимы работы - не менее 25:
- Сканирующая туннельная микроскопия постоянной высоты (CH-STM)
- Сканирующая туннельная спектроскопия (STS-STM)
- Сканирующая туннельная микроскопия электролюминесцентных свойств образца (EL-STM)
- Спин-поляризованная сканирующая туннельная микроскопия малых магнитных полей (SP-STM)
- Литография в режиме сканирующей туннельной микроскопии (STM-LIT)
- Атомно-силовая микроскопия постоянной высоты (CH-AFM)
- Атомно-силовая микроскопия высоких магнитных полей образца (M-AFM)
- Атомно-силовая микроскопия электропроводности и электрических потенциалов образца (EAFM)
- Атомно-силовая микроскопия теплопроводности и температуры образца (T-AFM)
- Атомно-силовая микроскопия тензора пьезосвойств и магнитострикции образца (PF-AFM)
- Атомно-силовая микроскопия упругих свойств образца (FM-AFM)
- Атомно-силовая микроскопия трения на поверхности образца (LF-AFM)
- Атомно-силовая микроскопия вертикальной вязкости образца (VV-AFM)
- Атомно-силовая микроскопия латеральной вязкости поверхности образца (LV-AFM)
- Атомно-силовая микроскопия адгезионных свойств образца (AD-AFM)
- Атомно-силовая микроскопия акустических свойств образца (A-AFM)
- Атомно-силовая микроскопия электрических полей на поверхности образца (EF-AFM)
- Литография в режиме атомно-силовой микроскопии (AFM-LIT)
- Вибрационная атомно-силовая микроскопия постоянной высоты (СH-VAFM)
- Вибрационная атомно-силовая микроскопия фазового контраста (PH-VAFM)
- Вибрационная атомно-силовая микроскопия пьезосвойств и магнитострикции образца (PF-VAFM)
- Вибрационная атомно-силовая микроскопия средних магнитных полей образца (M-VAFM)
- Вибрационная атомно-силовая микроскопия электрических потенциалов образца (EP-VAFM)
- Вибрационная атомно-силовая микроскопия емкостей поверхности образца (C-VAFM)
- Вибрационная атомно-силовая микроскопия зарядов и потенциалов поверхности образца методом зонда Кельвина (KP-VAFM)
- Литография в режиме вибрационной атомно-силовой микроскопии (VAFM-LIT)
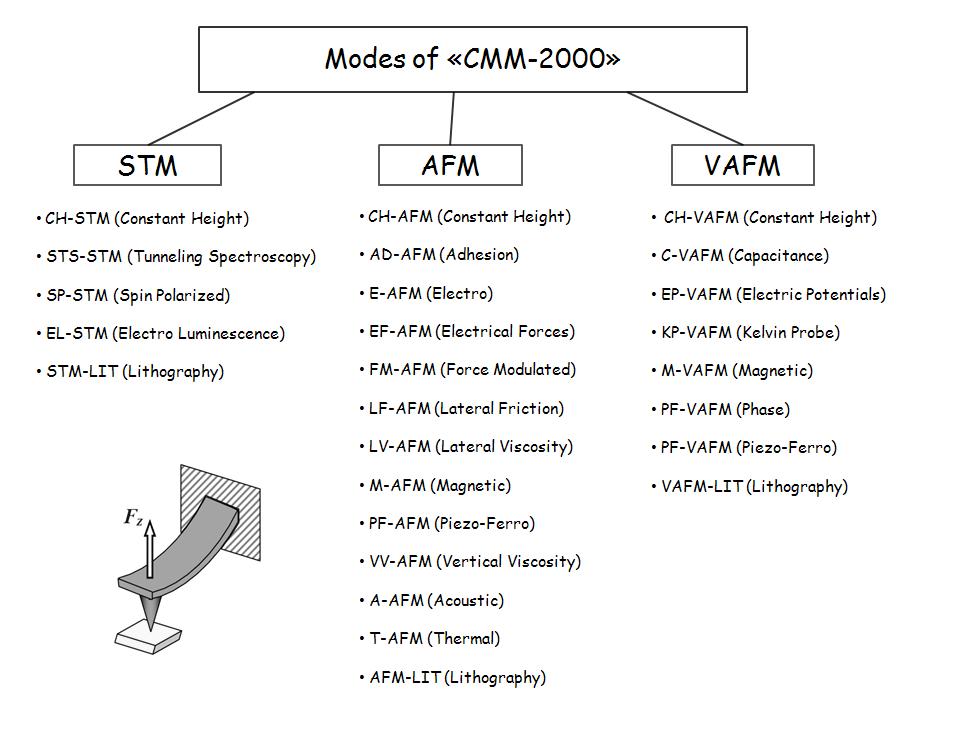
Опции программного обеспечения "Master scan": сканирование, кривые подвода и ВАХ, 3D-изображения, измерение размеров по сечениям, процентильные и матричные обработки, поточечная корреляция, анализ шероховатостей, Фурье, корреляционный, фрактальный, морфологический и гранулометрический анализы.

Краткий принцип работы "СММ-2000"
В режиме сканирующей туннельной микроскопии (STM) к образцу подводится платиновая игла с радиусом заострения около 10 Ангстрем. Исследуемые объекты должны иметь электропроводность не менее 10 кОм/мм или должны иметь толщину до 100 Ангстрем при нанесении на проводящую подложку. Между иглой и образцом прилагается напряжение около 1 В. На расстоянии около 10 Ангстрем с иглы на образец начинает стекать туннельный ток порядка 1 нА, сильно зависящий от расстояния и имеющий ширину канала стекания менее 1 Ангстрем, что определяет разрешение СТМ. Компьютер останавливает подвод иглы и начинает сканирование поверхности образца, поддерживая заданное оператором значение туннельного тока путем изменения высоты зависания иглы с точностью до 1 Ангстрем, записывая высоту иглы в каждой точке и формируя, таким образом, трехмерный кадр с информацией обо всех высотах рельефа.
В режиме атомно-силовой микроскопии (AFM) можно смотреть и неэлектропроводные объекты. Здесь используется кремниевая игла на упругой балке (кантилевер), которая при касании образца отгибается. Отгиб меряется с точностью до 1 Ангстрема лазерным датчиком и при сканировании поддерживается постоянным путем изменения высоты зависания основания балки. Из этих высот, так же как в STM, складывается трехмерный кадр рельефа. Разрешение высот рельефа в ACM находится на уровне разрешения СТМ в доли Ангстрем, а латеральное разрешение ACM определяется радиусом заострения его иглы и обычно составляет 5-20 Ангстрем. При малой жесткости образца (менее чем у полиэтилена) AFM можно включить в режим с вибрацией зонда и поддержанием постоянной амплитуды его колебаний при сканировании. При этом падает разрешение, но зонд меньше воздействует на образец - только в нижней точке своих колебаний.

